东京2024年2月7日–全球领先的半导体光掩模供应商Toppan Photomask宣布,已与IBM就使用极紫外(EUV)光刻技术的2纳米(nm)逻辑半导体工艺节点光掩模的联合研发达成协议。该协议还包括开发用于下一代半导体的高NA EUV光掩模。
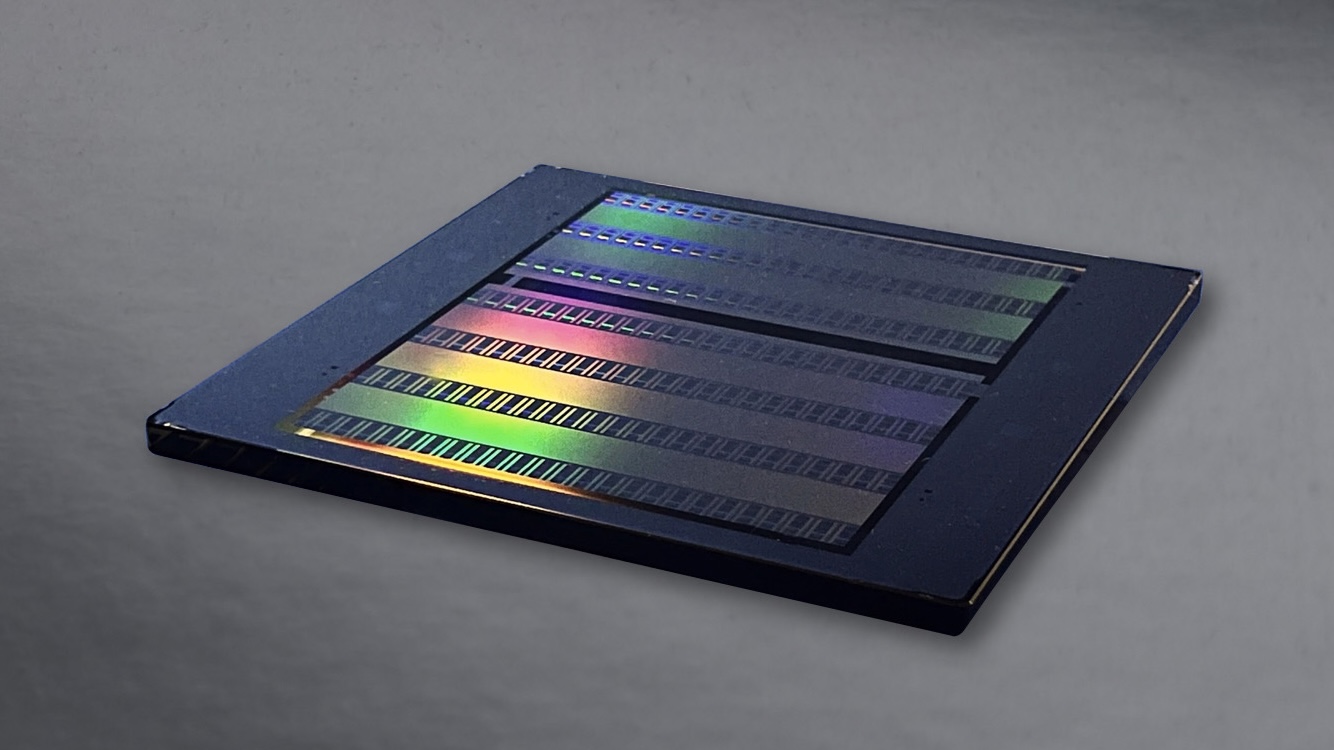
© Toppan Photomask Co., Ltd.
根据该协议,自2024年第1季度起的5年内,IBM和Toppan Photomask计划在Albany NanoTech Complex(美国纽约州奥尔巴尼)和Toppan Photomask的朝霞工厂(日本新座市)开发光掩模技术。
2nm及更高节点半导体的量产需要先进的材料选择和工艺控制的先进知识,这远远超出了使用ArF准分子激光作为光源的传统主流曝光技术的要求。IBM和Toppan Photomask协议整合这些基本材料和流程控制技术,为2nm及更高节点的量产提供解决方案。
IBM和Toppan Photomask有着长久的技术合作历史。2005年至2015年,IBM和Toppan Photomask(当时的凸版印刷)一直共同推进先进半导体光掩模的研究开发。联合开发从45nm节点开始,范围扩大到32nm、22/20nm和14nm节点,及初步的EUV光掩模开发活动。所积累的技术专长为全球半导体产业的发展做出了贡献。
此后,Toppan Photomask持续积极开发和生产用于EUV光刻的掩模和基板材料。此外,EUV量产掩模和下一代开发掩模的制造需要先进的多电子束光刻设备,Toppan Photomask安装了多套最先进的多电子束光刻系统,以满足最新的半导体技术路线需求。
Toppan Photomask总裁兼首席执行官二之宫照雄表示:“我们与IBM的合作对于两家公司来说都非常重要。这项协议将在支持半导体微型化、推动产业进步以及为日本半导体产业的发展做出贡献等方面,发挥至关重要的作用。我们非常荣幸能够在综合评估我们的技术能力和成本竞争力的基础上,被选为合作伙伴,我们将致力于加速实现2nm及更高节点制程。”
IBM全球半导体研发副总裁Huiming Bu表示:“利用EUV光刻系统和高NA EUV光刻系统的新型光掩模技术预计将在2nm及更高节点的半导体设计和制造中发挥关键作用。我们与Toppan Photomask的合作旨在通过开发新的解决方案来加速先进逻辑半导体的微型化创新,从而实现先进代工制造能力,这是日本半导体供应链的关键部分。”
关于Toppan Photomask
Toppan Photomask Co., Ltd.(TPC)是全球领先的半导体光掩模供应商,也是凸版控股株式会社(TYO:7911)的集团公司。TPC总部位于东京,利用其遍布全球的客户服务网络和位于主要地区的八个制造工厂,以业界领先的技术开发能力为半导体行业的发展做出贡献。TPC还将业务领域扩展到纳米压印模具及其他纳米制造产品。欲了解更多信息,请访问 https://www.photomask.co.jp/sc/。
前瞻性声明
本新闻稿包含IBM和Toppan Photomask基于当前认知、假设、预期的前瞻性陈述,涉及风险和不确定性,可能导致实际结果与当前预期存在重大差异的。
